Content
I. Dicing Saw
II.Ball Bonder
MC 1006A dicing saw |
MC B3 212 |
|
|
Standard Operation Procedure
Dicing Blades
MicroAutomation Hub blades (Tempress) for silicon :
- Model:12467
- Serie 401 Dicing Wheel
- Width of blade is 0.001″ to 0.0015″ (25.4µm to 38.1µm)
- Blade exposure is 0.025″ to 0.030″ (635µm to 762µm)
- Outer diameter is 2.187″ (55.55mm)
- Inside hole diameter is 0.750″ (19.05mm)
- 5 µm diamond
- Nickel bonded
Thermocarbon Inc. Hubless blades for Quartz or glass:
These blades are mounted on a Thermocarbon Flange Model 2.187BA-80S or 2.187BA-60S
- Model: 2.187-8A-40RU-3
- Dicemaster High Quality Diamond Blades
- Width of blade is 0.0078″ to 0.0082″ (198µm to 208µm)
- Blade exposure depends from the used flange. With flange 2.187BA-80S it is 0.080″ (2.032mm) and with flange 2.187BA-60S it is 0.060″ (1.524mm)
- Outer diameter is 2.187″ (55.55mm)
- 40µm diamond
- Resin bonded

Contact for training: Gaël Osowiecki
K&S Ball Bonder 4524 |
MC B1 147 |
|
|
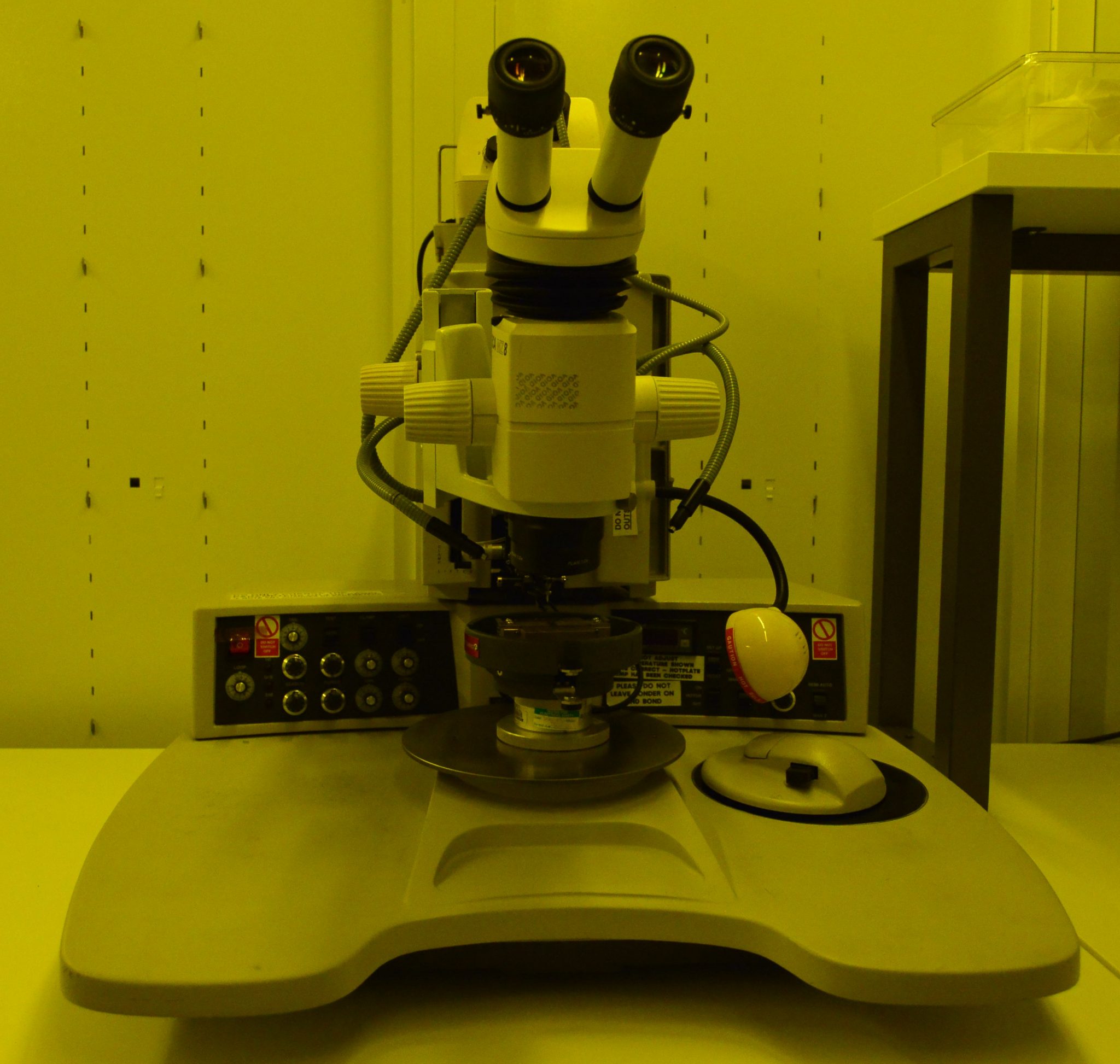
Contact for training: Gaël Osowiecki